上周四,韩半导体材料大佬三星公布,其下一代 2.5D 封装技术 I-Cube4 将要上市,该技术提升了逻辑性元器件和运行内存中间的通讯高效率,集成化 1 颗逻辑性芯片和 4 颗带宽测试运行内存(HBM)。
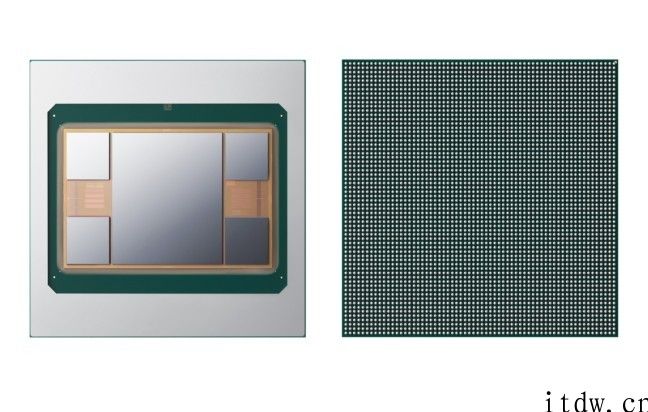
此外,该技术仍在维持性能的前提条件下,将中介公司层(Interposer)做得比纸还薄,薄厚仅有 100μm,节约了芯片室内空间。
澳大利亚电气专业技术权威专家阿德里安・吉本斯(Adrian Gibbons)对 I-Cube4 作了比较详尽的讲解。
一、高性能测算要求持续提升,封装设计方案难度系数提升
过去的两年中,高性能测算(HPC)行业的要求一直在持续增长,ML(深度学习)在 5G 边沿的运用也是增加了这一要求。
以往的两年,在 三维 NAND 等元器件中,2.5D 和 三维 芯片层叠已经逐渐替代传统式 IC 封装设计方案。
据阿德里安详细介绍,对比传统式的封装技术,2.5D 封装技术具有三项重要优点,分别是较低的芯片室内空间(footprint efficiency)、出色的热管理方法和更快的运作速率。
时下,在超算、大数据中心等行业,CPU、GPU 的核心总数持续提升,热管理方法的难度系数也在持续提升。
三星的新式 I-Cube4 封装技术包括 4 个 HBM 和 1 个逻辑性芯片,根据对映异构集成化,提升了逻辑性和运行内存中间的网站打开速度与电源效率,并可以运用于高性能测算、AI、5G、云等多种多样运用。
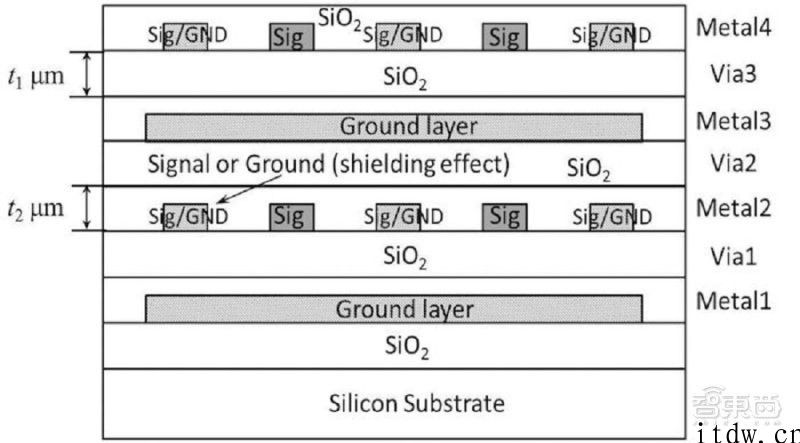
▲ 中介公司层可层叠完成带宽测试运行内存插口(来源于:Bo Pu)
二、三星操纵中介公司层薄厚,减少互联
中介公司层是好几个芯片控制模块或线路板传送电子信号的管路,也是插孔或连接头中间的电子信号插口。
一般来说,伴随着芯片复杂性的提升,硅底中介公司层也会愈来愈厚,但 I-Cube4 的中介公司层薄厚仅有 100μm,提升了商品性能。
据阿德里安详细介绍,I-Cube4 的 2.5D 封装技术减少了室内空间占有和输出功率耗损,也使互联较小,提升了商品的热管理方法。
此外,HBM 无线信道中的电信号完整性也是一个重要主要参数。根据将标准眼图掩膜运用到电子信号的眼图(Eye masks)上,可明确具体电源电路的传送品质,是评定数据信号详细度的最好方法之一。
因此 三星的科学研究工作人员选用该方式较为了二种不一样的涂层拓扑结构(layer topologies),以评定最好性能,还将二种不一样构造下的布线(trace)总宽和各布线中间的间距开展了较为。
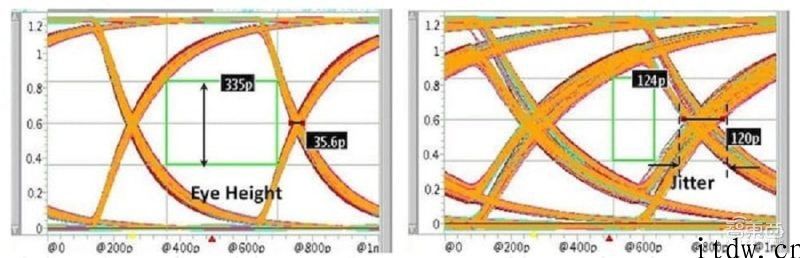
▲ 眼图的 6 mm布线(左)和 9 mm布线(右)(来源于:Bo Pu)
根据科学研究,三星科学研究工作人员发觉,二种构造在 3µm 处的性能类似,是其布线中间最少间距的 3 倍,遵照被称作 3W 的走线标准。这是由于在 PCB 设计方案中,布线中间会造成影响,应确保线间隔充足大。当线管理中心间隔不少于 3 倍图形界限时,则可维持 70% 的静电场不相互之间影响,这类走线标准称之为 3W 标准。
最终,三星还对于 I-Cube4 开发设计了无模貝构架(mold-free structure),根据预挑选检测,在生产制造全过程中找到伪劣产品,进而合理地提升良品率。此外,这也降低了封装流程,节约了成本费并减少了资金周转時间。
三、寄生参数或危害其商品性能
但是阿德里安提及,I-Cube4 为了更好地得到高测算性能,必须 HBM 尽量地贴近逻辑性芯片,这也导致了寄生参数(parasitic parameter)的发生。
尽管寄生参数一般发生在 PCB 板的设计方案中,关键造成的缘故是线路板和元器件本身引进的电阻器、电容器、电感器等相互之间影响,但这一难题也会发生在圆晶方面上。这种寄生参数会危害商品的性能,使其没法做到设计方案标值。
除此之外,过薄的中介公司层也非常容易发生弯折或翘起来等状况。据三星官方网站详细介绍,三星的科学研究工作人员根据挑选适合的中介公司层原材料与薄厚,解决了这一难题。
三星代工生产单位销售市场发展战略副总裁 Moonsoo Kang 觉得,I-Cube4 的开发设计对三星的顾客尤为重要。他说道:“伴随着高性能测算的爆发式提高,出示一种具备对映异构集成化技术的总体封装解决方法尤为重要,I-Cube4 提升 了芯片的总体性能和电源效率。”
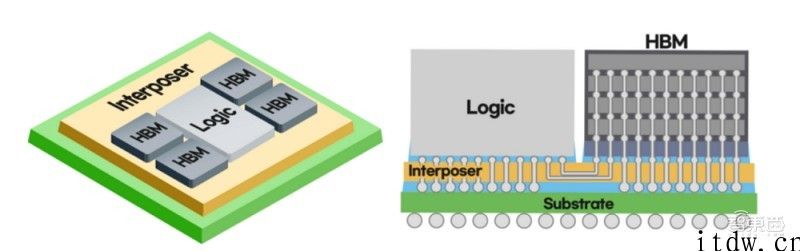
▲ I-Cube4 封装构造效果图渲染(来源于:三星)
总结:I-Cube4 或提升 其晶圆代工整体实力
封装技术做为芯片生产制造的最终一道工艺流程,既能够 避免 空气中的残渣浸蚀芯片电源电路,也是芯片与外界电源电路的公路桥梁,立即危害着芯片排热等性能。
一方面,储存网络带宽较低,储存与逻辑性芯片中间存有一堵“运行内存墙”;另一方面,高性能CPU的构造愈来愈繁杂,生产率较低。
为了更好地处理这种难题,tsmc、intel、三星等芯片大佬都是在加快对封装技术的布署,三星此次发布的 I-Cube4 代表着其封装技术的再一次发展,能够 提升三星代工生产业务流程的芯片产品合格率、减少封装成本费,或将从总体上提升其晶圆代工业务流程的竞争能力。

1、IT大王遵守相关法律法规,由于本站资源全部来源于网络程序/投稿,故资源量太大无法一一准确核实资源侵权的真实性;
2、出于传递信息之目的,故IT大王可能会误刊发损害或影响您的合法权益,请您积极与我们联系处理(所有内容不代表本站观点与立场);
3、因时间、精力有限,我们无法一一核实每一条消息的真实性,但我们会在发布之前尽最大努力来核实这些信息;
4、无论出于何种目的要求本站删除内容,您均需要提供根据国家版权局发布的示范格式
《要求删除或断开链接侵权网络内容的通知》:https://itdw.cn/ziliao/sfgs.pdf,
国家知识产权局《要求删除或断开链接侵权网络内容的通知》填写说明: http://www.ncac.gov.cn/chinacopyright/contents/12227/342400.shtml
未按照国家知识产权局格式通知一律不予处理;请按照此通知格式填写发至本站的邮箱 wl6@163.com



