这篇文章内容给诸位网民产生的新闻资讯是:中国科学院上海光机所测算光刻工艺科学研究获得进度 敬请赏析下面
IT老大 6 月 10 日信息 据中科院网址,近日,中科院上海市电子光学精密的机器设备研究室信息内容电子光学与光电科技试验室明确提出一种根据虚似边(Virtual Edge)与双采样频率像素化掩模图型(Mask pixelation with two-phase sampling)的迅速电子光学邻近效应修正技术性(Optical proximity correction, OPC),模拟仿真结果显示该技术性具备较高的修正高效率。
据了解,OPC 技术性根据调节掩模图型的透过率遍布修正电子光学邻近效应,进而提升成像品质。根据实体模型的 OPC 技术性是完成 90nm 及下列技术性连接点集成电路芯片生产制造的重要测算光刻工艺之一。
上海光机所科技人员明确提出的这类根据虚似边与双采样频率像素化掩模图型的迅速电子光学邻近效应修正技术性,可以将不一样种类的成像失帧归纳为二种种类的成像出现异常,即内缩出现异常与外伸出现异常。运用不一样的成像异常检测模版,先后在掩模图型的边沿和转角等轮廊偏位分辨部位开展部分成像异常检测,明确出现异常种类及出现异常地区的范畴。依据异常检测部位与出现异常地区范畴,响应式造成虚似边。根据挪动虚似边调节掩模的部分透过率遍布,进而修正部分成像出现异常。依靠修正对策和修正管束,完成高效率的部分修正和全局性轮廊高保真操纵。此外,双采样频率像素化掩模灵活运用了成像系统软件的透射受到限制特性,在粗取样网格图上开展成像测算与异常检测,在精取样网格图上开展掩模修正,兼具了成像测算高效率与掩模修正屏幕分辨率。运用多种多样掩模图型开展认证,模拟仿真结果显示该 OPC 技术性的修正高效率好于常见的根据启发式算法的 OPC 技术性。
IT老大掌握到,有关科研成果发布在 Optics Express 上。
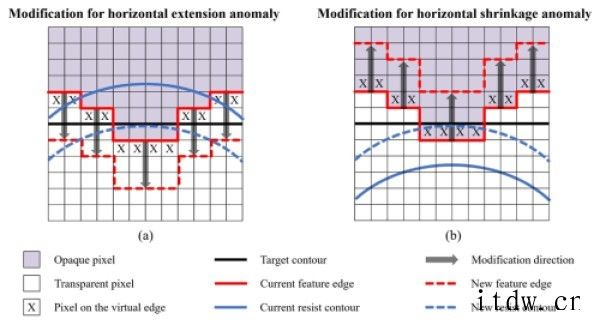
▲根据虚似边的成像出现异常修正,(a)外伸出现异常修正,(b)内缩出现异常修正 | 彩色图库:中科院网址

1、IT大王遵守相关法律法规,由于本站资源全部来源于网络程序/投稿,故资源量太大无法一一准确核实资源侵权的真实性;
2、出于传递信息之目的,故IT大王可能会误刊发损害或影响您的合法权益,请您积极与我们联系处理(所有内容不代表本站观点与立场);
3、因时间、精力有限,我们无法一一核实每一条消息的真实性,但我们会在发布之前尽最大努力来核实这些信息;
4、无论出于何种目的要求本站删除内容,您均需要提供根据国家版权局发布的示范格式
《要求删除或断开链接侵权网络内容的通知》:https://itdw.cn/ziliao/sfgs.pdf,
国家知识产权局《要求删除或断开链接侵权网络内容的通知》填写说明: http://www.ncac.gov.cn/chinacopyright/contents/12227/342400.shtml
未按照国家知识产权局格式通知一律不予处理;请按照此通知格式填写发至本站的邮箱 wl6@163.com



